Szkło szybko staje sięmateriał platformydla rynków terminalowych prowadzonych przezcentra danychItelekomunikacjaW centrach danych stanowi podstawę dwóch kluczowych nośników opakowań:architektury układów scalonychIwejście/wyjście optyczne (I/O).
Jegoniski współczynnik rozszerzalności cieplnej (CTE)Inośniki szklane kompatybilne z głębokim ultrafioletem (DUV)włączonowiązanie hybrydoweIObróbka tylnej strony cienkiego wafla o grubości 300 mmaby stały się ujednoliconymi przepływami produkcyjnymi.
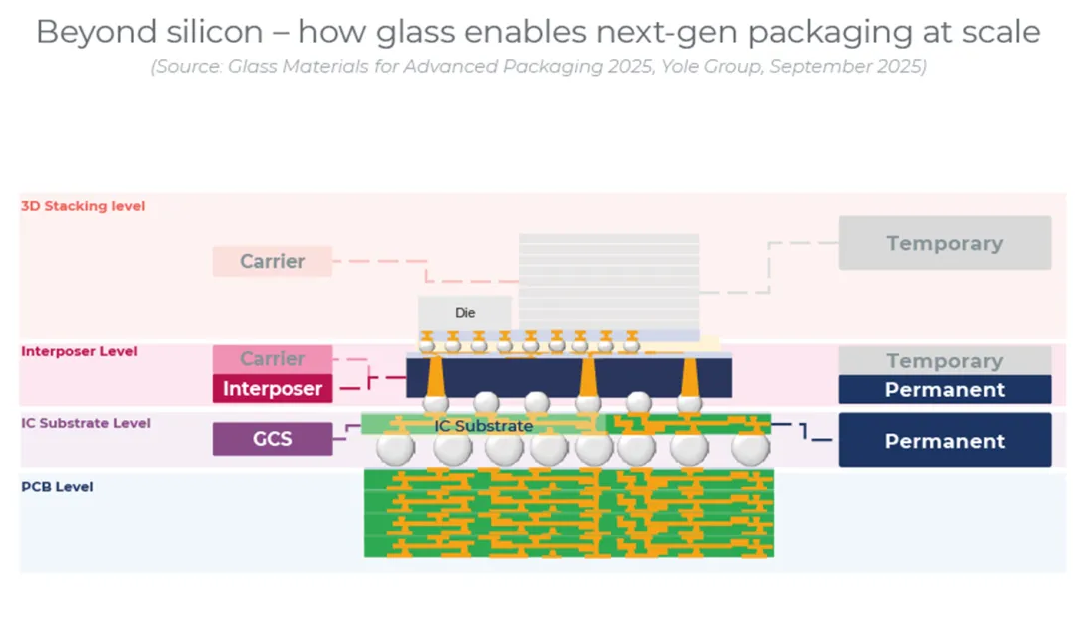
W miarę jak moduły przełączników i akceleratorów stają się większe niż wymiary płytek krokowych,nośniki panelistają się niezbędne. Rynekpodłoża z rdzeniem szklanym (GCS)przewiduje się, że osiągnie460 milionów dolarów do 2030 roku, a optymistyczne prognozy sugerują powszechną adopcję na poziomie2027–2028. Tymczasem,szklane wkładkiOczekuje się, że przekroczą400 milionów dolarównawet przy konserwatywnych prognozach istały segment nośny ze szkłareprezentuje rynek około500 milionów dolarów.
In zaawansowane pakowanieszkło ewoluowało od prostego elementu do stania siębiznes platformowy. Dlanośniki szklanegenerowanie przychodów przesuwa się zcennik za panel to ekonomia na cyklgdzie rentowność zależy odcykle ponownego użycia, wydajność odklejania laserowego/UV, wydajność procesu, Iłagodzenie uszkodzeń krawędzi. Ta dynamika przynosi korzyści dostawcom oferującymPortfele oceniane według CTE, dostawcy pakietówsprzedaż zintegrowanych stosównośnik + klej/LTHC + debond, Iregionalni dostawcy odzyskuspecjalizująca się w zapewnianiu jakości optycznej.
Firmy posiadające bogate doświadczenie w zakresie szkła, takie jakPlan Optik, znany ze swojegonośniki o wysokiej płaskościzzaprojektowane geometrie krawędziIkontrolowana transmisja—znajdują się w optymalnym miejscu w tym łańcuchu wartości.
Podłoża z rdzeniem szklanym pozwalają obecnie na zwiększenie rentowności produkcji paneli wyświetlaczy dziękiTGV (przez szkło), drobny RDL (warstwa redystrybucji), Iprocesy akumulacjiLiderami rynku są ci, którzy opanowali kluczowe interfejsy:
-
Wysokowydajne wiercenie/trawienie TGV
-
Wypełnienie miedziane bez pustych przestrzeni
-
Litografia panelowa z adaptacyjnym wyrównaniem
-
2/2 µm L/S (linia/przerwa)wzorowanie
-
Technologie obsługi paneli sterowanych za pomocą odkształceń
Dostawcy podłoży i OSAT współpracujący z producentami szkła ekspozycyjnego dokonują konwersjipojemność dużej powierzchnidokorzyści kosztowe w przypadku pakowania na skalę panelową.

Od nośnika do pełnoprawnego materiału platformowego
Szkło zmieniło się ztymczasowy przewoźnikdokompleksowa platforma materiałowaDozaawansowane pakowanie, wpisując się w megatrendy takie jakintegracja chipletów, panelizacja, układanie w pionie, Iwiązanie hybrydowe—jednocześnie zacieśniając budżety namechaniczny, termiczny, Ipomieszczenie czystewydajność.
Jakoprzewoźnik(zarówno płytka, jak i panel),szkło przezroczyste o niskim współczynniku CTEumożliwiawyrównanie minimalizujące stresIodklejanie laserowe/UV, poprawiając plonywafle o grubości poniżej 50 µm, przepływy procesów zaplecza, Ipanele rekonstruowane, osiągając w ten sposób wielofunkcyjną efektywność kosztową.
Jakopodłoże z rdzeniem szklanym, zastępuje rdzenie organiczne i wspieraprodukcja na poziomie paneli.
-
TGV-yzapewniają gęste pionowe zasilanie i trasowanie sygnału.
-
SAP RDLprzesuwa granice okablowania do2/2 µm.
-
Płaskie powierzchnie z regulacją współczynnika CTEminimalizuje odkształcenia.
-
Przezroczystość optycznaprzygotowuje podłoże dooptyka współpakowana (CPO).
Tymczasem,rozpraszanie ciepławyzwania są rozwiązywane poprzezstrugi miedziane, przelotki zszywane, sieci zasilania od tyłu (BSPDN), Ichłodzenie dwustronne.
Jakoszklany interposermateriał ten sprawdza się w ramach dwóch odrębnych paradygmatów:
-
Tryb pasywny, umożliwiając realizację ogromnych architektur 2.5D AI/HPC i przełączników, które osiągają gęstość okablowania i liczbę wypustek nieosiągalną w przypadku układów krzemowych przy porównywalnych kosztach i powierzchni.
-
Tryb aktywny, integrującSIW/filtry/antenyImetalizowane rowki lub światłowody pisane laserowow podłożu, składając ścieżki RF i kierując optyczne wejścia/wyjścia do urządzeń peryferyjnych z minimalnymi stratami.
Perspektywy rynku i dynamika branży
Według najnowszej analizyGrupa Yole, materiały szklane stały sięcentralne miejsce w rewolucji w pakowaniu półprzewodników, napędzane przez główne trendy wsztuczna inteligencja (AI), obliczenia o wysokiej wydajności (HPC), Łączność 5G/6G, Ioptyka współpakowana (CPO).
Analitycy podkreślają, że szkłounikalne właściwości—w tym jegoniskie CTE, lepsza stabilność wymiarowa, Iprzezroczystość optyczna—uczynić niezbędnym do spełnieniawymagania mechaniczne, elektryczne i termicznepakietów nowej generacji.
Yole zauważa dalej, żecentra danychItelekomunikacjapozostaćgłówne silniki wzrostudo stosowania szkła w opakowaniach, podczas gdyautomobilowy, obrona, Iwysokiej klasy elektronika użytkowawnieść dodatkowy impuls. Sektory te są coraz bardziej zależne odintegracja chipletów, wiązanie hybrydowe, Iprodukcja na poziomie paneli, gdzie szkło nie tylko poprawia wydajność, ale także obniża całkowity koszt.
Wreszcie pojawienie sięnowe łańcuchy dostaw w Azji—szczególnie wChiny, Korea Południowa i Japonia—jest identyfikowany jako kluczowy czynnik umożliwiający skalowanie produkcji i wzmacnianieglobalny ekosystem dla zaawansowanego szkła opakowaniowego.
Czas publikacji: 23-10-2025
